聚焦离子束(Focused Ion beam, FIB)的系统是利用电透镜将离子束聚焦成非常小尺寸的显微切割仪器。目前商用系统的离子束为液相金属离子源,金属材质为镓(Ga),因为镓元素具有低熔点、低蒸气压及良好的抗氧化力;典型的离子束显微镜包括液相金属离子源、电透镜、扫描电极、二次粒子侦测器、5 - 6轴向移动的试片基座、真空系统、抗振动和磁场的装置、电子控制面板和计算机等硬设备,外加电场(Suppressor)于液相金属离子源可使液态镓形成细小尖端,再加上负电场(Extractor) 牵引尖端的镓,而导出镓离子束,以电透镜聚焦,经过一连串变化孔径可决定离子束的大小,再经过二次聚焦至试片表面,利用物理碰撞来达到切割之目的。 将扫描电子显微镜与FIB集成为一个系统,可充分发挥各自的优点,加工过程中可利用电子束实时监控样品加工进度可更好的控制加工精度。
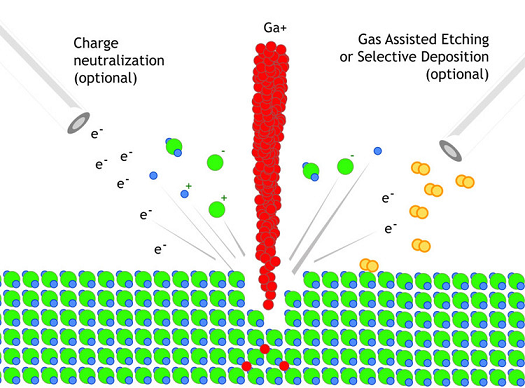
无论是透射电镜还是扫描透射电镜样品都需要制备非常薄的样品,以便电子能够穿透样品,形成电子衍射图像。传统的制备TEM样品的方法是机械切片研磨,用这种方法只能分析大面积样品。采用聚焦离子束则可以对样品的某一局部切片进行观察。与切割横截面的方法一样,制作TEM样品是利用聚焦离子束从前后两个方向加工,后在中间留下一个薄的区域作为TEM观察的样品。下图所示为TEM制样的工艺过程。